Intel「Lakefield」正式発表 [CPU]
Intelが「Lakefield」を正式発表した。
この「Lakefield」、モノ的にはSoCだが今までのSoCとは大きく違う。
それはこれまで別チップをシステムボードに実装してきた機能までを一つのパッケージに収めている事。
これはメインメモリのDRAMをも含み、消費電力低減と動作速度向上という相反する性能向上を同時に実現する。
これを実現する技術が各チップを三次元積層する「Foveros 3D packaging technology」(以下Foveros)というものだ。
それは以下の図のように、最下層のパッケージ、その上に各種チップセット、CPU本体、DRAMの順で積み上げている。
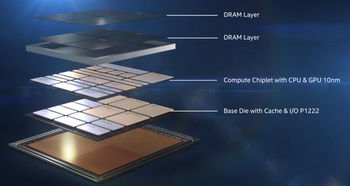
Intelの公式資料より拝借。
このような構造であるため、CPUを挟むチップセットとDRAMはCPUの発熱の影響を強く受ける。
従ってFoverosは低消費電力製品向けの技術だと言える。
事実「Lakefield」はTDP 7Wの製品であり、主に小型のモバイルPCやタブレット等に向けたものだ。
だが、将来的にはより高いTDP(上限は精々25W程度だろうが)の製品にもFoverosは採用されていくと私は予想している。
参考:
CES 2019:インテルの3Dチップは、「3つの奇跡」を乗り越えて実用化に向かう
https://wired.jp/2019/01/10/intel-lakefield/
Lakefield正式発表!
https://ascii.jp/elem/000/004/015/4015985/



